SMT는 기존 솔더 페이스트 공기 리플로우 용접 캐비티 분석 및 솔루션(2023 Essence Edition)을 사용하므로 그럴 자격이 있습니다!
1 소개

회로 기판 어셈블리에서는 먼저 회로 기판 솔더 패드에 솔더 페이스트를 인쇄한 다음 다양한 전자 부품을 부착합니다. 마지막으로 리플로우로 이후 솔더 페이스트의 주석 비드가 녹고 모든 종류의 전자 부품과 회로 기판의 솔더 패드가 함께 용접되어 전기 서브모듈의 조립이 실현됩니다. 표면 장착 기술(sMT)은 시스템 레벨 패키지(siP), 볼 그리드(BGA) 장치, 전력 베어 칩, 정사각형 평면 핀리스 패키지(쿼드 aatNo-lead, QFN이라고도 함)와 같은 고밀도 패키징 제품에 점점 더 많이 사용되고 있습니다. ) 장치.
솔더 페이스트 용접 공정 및 재료의 특성으로 인해 이러한 대형 솔더 표면 장치의 리플로우 용접 후에 솔더 용접 영역에 구멍이 생기며 이는 제품 성능의 전기적 특성, 열적 특성 및 기계적 특성에 영향을 미칩니다. 제품 고장으로 이어질 수도 있으므로 솔더 페이스트 리플로우 용접 캐비티를 개선하는 것은 해결해야 할 프로세스 및 기술 문제가 되었습니다. 일부 연구자들은 BGA 솔더 볼 용접 캐비티의 원인을 분석하고 연구하여 개선 솔루션을 제공했습니다. 기존 솔더 QFN의 페이스트 리플로우 용접 공정 용접 면적이 다음보다 큽니다. 10mm2 또는 6mm2보다 큰 용접 면적의 베어 칩 솔루션은 부족합니다.
용접 구멍을 개선하려면 프리폼 솔더 용접과 진공 환류로 용접을 사용하십시오. 조립식 솔더에는 플럭스를 지정하기 위한 특수 장비가 필요합니다. 예를 들어, 칩을 조립식 솔더 위에 직접 배치한 후 칩이 오프셋되고 심각하게 기울어집니다. 플럭스 마운트 칩이 리플로우된 후 포인트인 경우 프로세스는 두 번의 리플로우로 증가하며 조립식 솔더 및 플럭스 재료의 비용은 솔더 페이스트보다 훨씬 높습니다.
진공 환류 장비는 더 비싸고 독립 진공 챔버의 진공 용량이 매우 낮으며 비용 성능이 높지 않으며 주석 비산 문제가 심각하여 고밀도 및 작은 피치 적용에 중요한 요소입니다. 제품. 본 논문에서는 기존의 솔더 페이스트 리플로우 용접 공정을 기반으로 용접 캐비티를 개선하고 용접 캐비티로 인해 발생하는 접합 및 플라스틱 씰 균열 문제를 해결하기 위한 새로운 2차 리플로우 용접 공정을 개발하고 소개합니다.
2 솔더 페이스트 인쇄 리플로우 용접 캐비티 및 생산 메커니즘
2.1 용접 캐비티
리플로우 용접 후 제품을 X-Ray로 테스트했습니다. 그림 1에서 볼 수 있듯이, 밝은 색상으로 표시된 용접 영역의 구멍은 용접층의 솔더 부족으로 인한 것으로 나타났습니다.
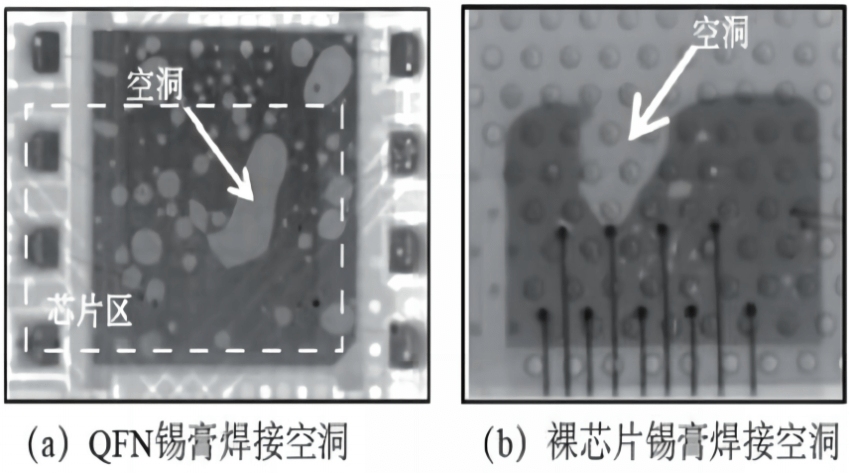
기포 구멍의 X선 감지
2.2 용접 캐비티의 형성 메커니즘
sAC305 솔더 페이스트를 예로 들면, 주요 구성과 기능은 표 1에 나와 있습니다. 플럭스와 주석 비드는 페이스트 형태로 함께 결합됩니다. 주석 솔더와 플럭스의 중량비는 약 9:1이고, 부피비는 약 1:1입니다.

솔더 페이스트가 인쇄되어 다양한 전자 부품과 함께 장착된 후 솔더 페이스트는 환류로를 통과할 때 예열, 활성화, 환류 및 냉각의 4단계를 거칩니다. 솔더 페이스트의 상태는 그림 2에서 볼 수 있듯이 여러 단계의 온도에 따라 다릅니다.
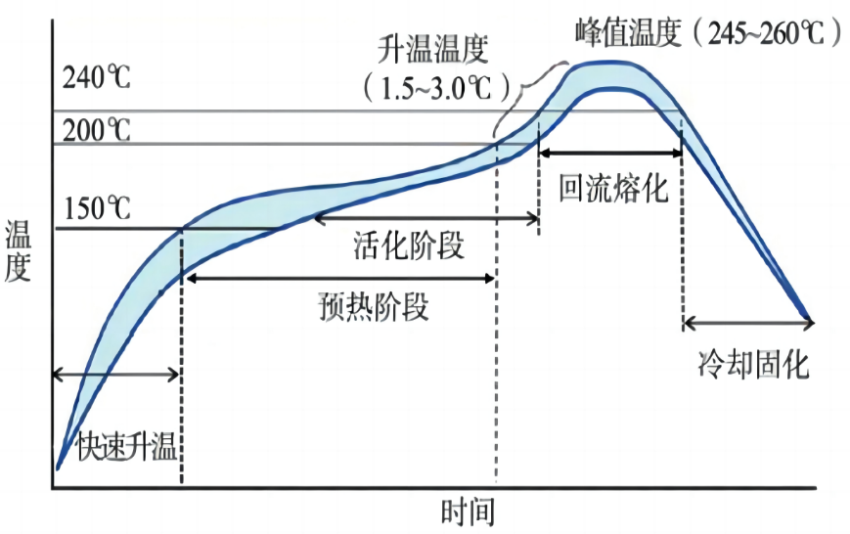
리플로우 솔더링 분야별 프로필 참고자료
예열 및 활성화 단계에서 솔더 페이스트 플럭스의 휘발성 성분은 가열되면 가스로 휘발됩니다. 동시에 용접층 표면의 산화물이 제거되면 가스가 생성됩니다. 이러한 가스 중 일부는 휘발하여 솔더 페이스트를 남기고 솔더 비드는 플럭스의 휘발로 인해 단단히 응축됩니다. 환류 단계에서 솔더 페이스트에 남아 있는 플럭스는 빠르게 증발하고, 주석 비드는 녹고, 소량의 플럭스 휘발성 가스와 주석 비드 사이의 대부분의 공기는 시간 내에 분산되지 않으며, 잔류물은 용융 주석과 용융 주석의 장력 하에 있는 햄버거 샌드위치 구조는 회로 기판의 납땜 패드와 전자 부품에 걸리며, 액체 주석에 싸인 가스는 상승 부력에 의해서만 빠져나가기가 어렵습니다. 상부 용융 시간은 매우 길다. 짧은. 용융된 주석이 냉각되어 고체 주석이 되면 그림 3과 같이 용접층에 기공이 생기고 납땜 구멍이 형성됩니다.
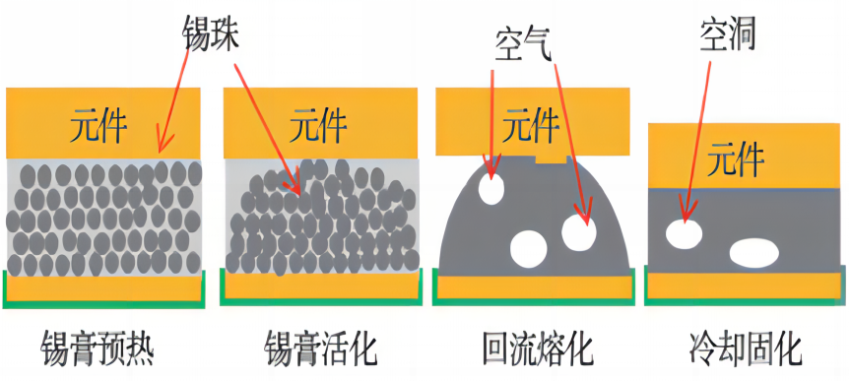
솔더 페이스트 리플로우 용접으로 인해 생성된 보이드의 개략도
용접 캐비티의 근본 원인은 용융 후 솔더 페이스트에 싸인 공기나 휘발성 가스가 완전히 배출되지 않기 때문입니다. 영향을 미치는 요인에는 솔더 페이스트 재료, 솔더 페이스트 인쇄 모양, 솔더 페이스트 인쇄 양, 환류 온도, 환류 시간, 용접 크기, 구조 등이 포함됩니다.
3. 솔더페이스트 인쇄 리플로우 용접 홀의 영향요인 검증
리플로우 용접 보이드의 주요 원인을 확인하고 솔더 페이스트에 의해 인쇄된 리플로우 용접 보이드를 개선할 수 있는 방법을 찾기 위해 QFN 및 베어 칩 테스트를 사용했습니다. QFN 및 베어 칩 솔더 페이스트 리플로우 용접 제품 프로필은 그림 4에 나와 있습니다. QFN 용접 표면 크기는 4.4mmx4.1mm이고 용접 표면은 주석 도금층(100% 순수 주석)입니다. 베어 칩의 용접 크기는 3.0mmx2.3mm이고 용접층은 스퍼터링된 니켈-바나듐 바이메탈 층이며 표면층은 바나듐입니다. 기판의 용접패드는 무전해 니켈-팔라듐 금도금으로 두께는 0.4μm/0.06μm/0.04μm로 하였다. SAC305 솔더 페이스트를 사용하였으며, 솔더 페이스트 프린팅 장비는 DEK Horizon APix, 환류로 장비는 BTUPyramax150N, 엑스레이 장비는 DAGExD7500VR을 사용하였다.
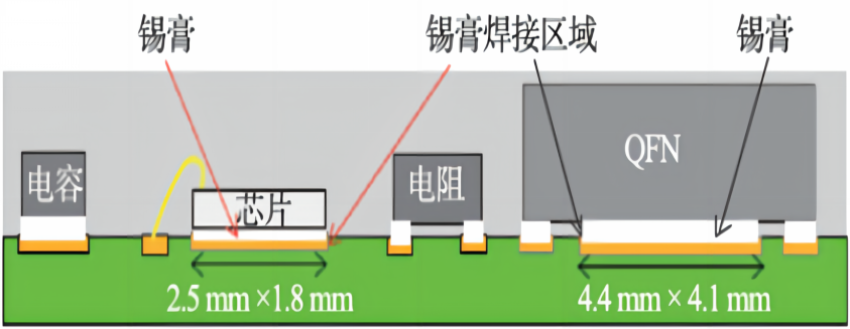
QFN 및 베어 칩 용접 도면
테스트 결과의 비교를 용이하게 하기 위해 Table 2의 조건으로 리플로우 용접을 실시하였다.

리플로우 용접조건표
표면실장 및 리플로우 용접이 완료된 후 X-Ray로 용접층을 검출한 결과, 그림 5와 같이 QFN 하단과 베어칩의 용접층에 큰 구멍이 있는 것을 확인하였다.
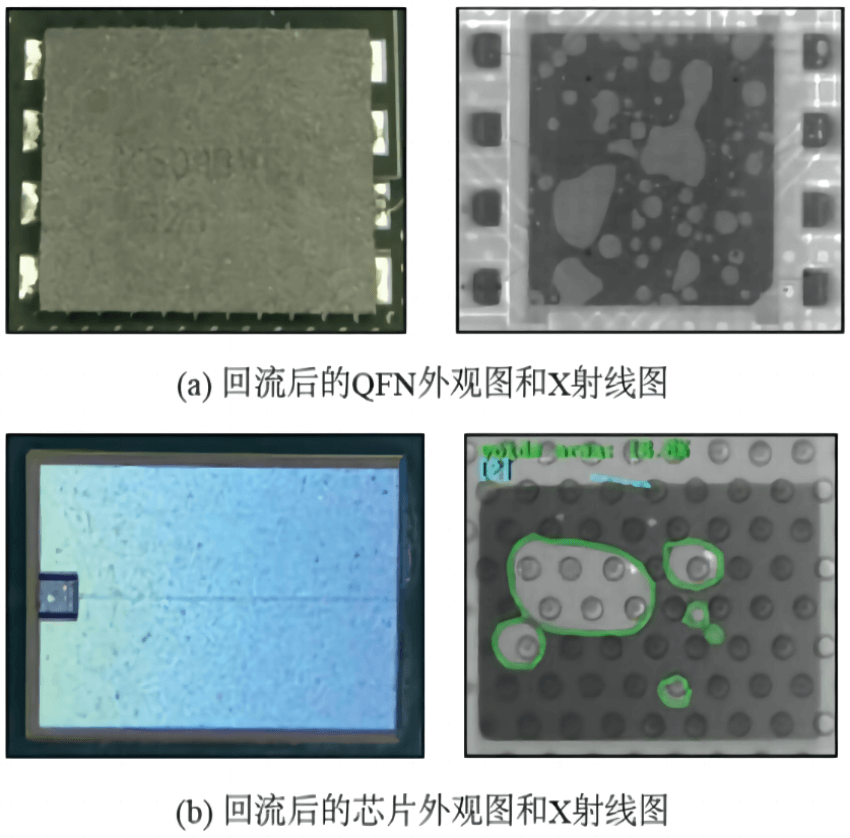
QFN 및 칩 홀로그램(X선)
주석 비드 크기, 강철 메쉬 두께, 개방 면적 비율, 강철 메쉬 모양, 환류 시간 및 최고로 온도가 모두 리플로우 용접 보이드에 영향을 미치기 때문에 많은 영향 요인이 있으며 이는 DOE 테스트를 통해 직접 검증되며 실험 횟수도 많습니다. 그룹이 너무 커집니다. 상관관계 비교 검정을 통해 주요 영향요인을 신속하게 선별하고 파악한 후, DOE를 통해 주요 영향요인을 더욱 최적화하는 것이 필요합니다.
3.1 솔더 홀 및 솔더 페이스트 주석 비드의 치수
Type3(비드 크기 25~45μm)SAC305 솔더 페이스트 테스트의 경우 다른 조건은 변경되지 않았습니다. 리플로우 후 솔더 층의 홀을 측정하고 Type4 솔더 페이스트와 비교합니다. 솔더 층의 구멍은 두 종류의 솔더 페이스트 사이에 크게 다르지 않은 것으로 나타났습니다. 이는 서로 다른 비드 크기를 가진 솔더 페이스트가 솔더 층의 구멍에 뚜렷한 영향을 미치지 않으며 이는 영향 요인이 아니라는 것을 나타냅니다. 도 1에 도시된 바와 같이. 6 그림과 같습니다.

입자 크기가 다른 금속 주석 분말 구멍의 비교
3.2 용접 캐비티 및 인쇄 철망의 두께
리플로우 후 50μm, 100μm, 125μm 두께의 인쇄된 철망을 사용하여 용접층의 캐비티 면적을 측정했으며 다른 조건은 변경되지 않았습니다. 서로 다른 두께의 스틸 메쉬(솔더 페이스트)가 QFN에 미치는 영향을 75μm 두께의 인쇄된 스틸 메쉬와 비교한 결과, 스틸 메쉬의 두께가 증가함에 따라 캐비티 면적이 점차 감소하는 것을 알 수 있었습니다. 특정 두께(100μm)에 도달하면 그림 7과 같이 강철 메쉬의 두께가 증가함에 따라 캐비티 영역이 반전되어 증가하기 시작합니다.
이는 솔더 페이스트의 양이 증가하면 환류가 있는 액체 주석이 칩으로 덮이고 잔류 공기 배출구가 4개 측면에서만 좁아진다는 것을 보여줍니다. 솔더 페이스트의 양이 변경되면 잔류 공기 배출구도 증가하고 액체 주석에 싸인 공기 또는 액체 주석에서 빠져나오는 휘발성 가스로 인해 액체 주석이 QFN 및 칩 주위로 튀는 현상이 발생합니다.
테스트 결과 강철 메쉬의 두께가 증가함에 따라 공기 또는 휘발성 가스의 누출로 인한 기포 파열도 증가하고 이에 따라 QFN 및 칩 주변에 주석이 튀는 확률도 증가하는 것으로 나타났습니다.

두께가 다른 철망의 구멍 비교
3.3 용접 공동과 철망 개구부의 면적비
개구율 100%, 90%, 80%의 인쇄된 강철 메쉬를 테스트했으며 다른 조건은 변경되지 않았습니다. 리플로우 후 용접층의 캐비티 면적을 측정하여 개구율 100%의 인쇄된 철망과 비교하였습니다. 그림 8에서 보는 바와 같이 개구율 100%와 90%, 80% 조건에서 용접층의 캐비티에는 큰 차이가 없는 것으로 나타났다.

서로 다른 철망의 서로 다른 개구부 면적의 캐비티 비교
3.4 용접 캐비티 및 인쇄된 강철 메쉬 모양
스트립 b와 경사 그리드 c의 솔더 페이스트의 인쇄 형태 테스트에서 다른 조건은 변경되지 않았습니다. 리플로우 후 용접층의 캐비티 면적을 측정하여 그리드 a의 인쇄 형상과 비교합니다. 그림 9와 같이 그리드, 스트립, 경사 그리드 조건에서 용접층의 캐비티에는 큰 차이가 없는 것으로 나타났습니다.
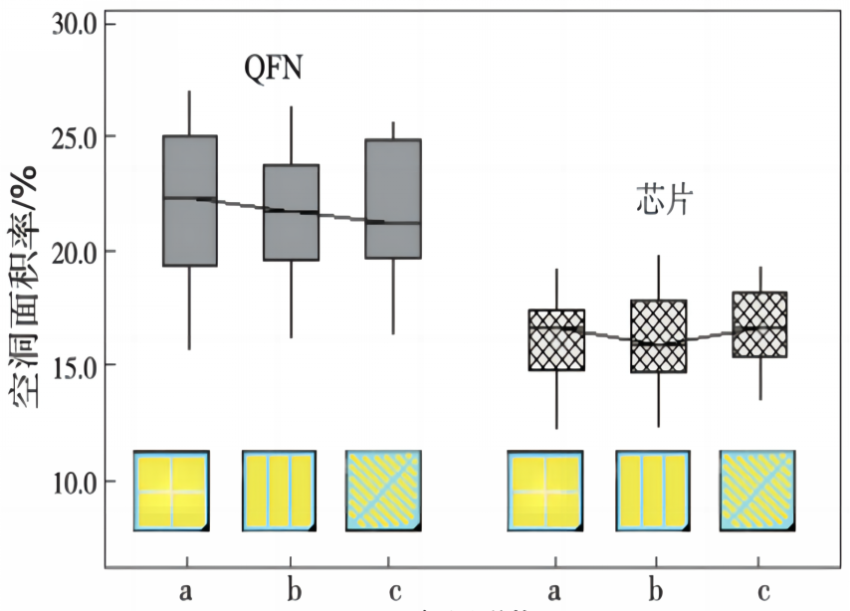
강철 메쉬의 다양한 개방 모드에 따른 구멍 비교
3.5 용접 캐비티 및 환류 시간
환류 시간을 연장(70초, 80초, 90초)한 후 다른 조건은 변경하지 않고 환류 후 용접층의 구멍을 측정한 결과 환류 시간 60초와 비교하여 환류시간이 증가함에 따라 용접구멍 면적은 감소하였으나 Figure 10과 같이 시간이 증가함에 따라 감소폭은 점차 감소하였다. 이는 환류시간이 부족한 경우 환류시간이 증가함을 보여준다. 용융된 액체 주석에 싸인 공기가 완전히 넘치는데 도움이 되지만, 환류 시간이 특정 시간으로 증가한 후에는 액체 주석에 싸인 공기가 다시 넘치기 어렵습니다. 환류 시간은 용접 캐비티에 영향을 미치는 요인 중 하나입니다.

다양한 환류 시간 길이의 비교는 무효입니다.
3.6 용접 캐비티 및 최고 로 온도
240℃ 및 250℃ 최고 로 온도 테스트 및 기타 조건을 변경하지 않은 상태에서 리플로우 후 용접층의 캐비티 면적을 측정하고 260℃ 최고 로 온도와 비교한 결과 서로 다른 최고 로 온도 조건에서 용접층의 캐비티가 발생하는 것으로 나타났습니다. 그림 11에서 볼 수 있듯이 QFN과 칩의 용접층은 크게 변하지 않았습니다. 최고로 온도의 차이가 QFN과 칩 용접층의 구멍에 뚜렷한 영향을 미치지 않으며 이는 영향 요인이 아님을 보여줍니다.

서로 다른 최고 온도의 비교가 무효화됨
위의 테스트는 QFN과 칩의 용접층 캐비티에 영향을 미치는 중요한 요소가 환류 시간과 강철 메쉬 두께임을 나타냅니다.
4 솔더 페이스트 인쇄 리플로우 용접 캐비티 개선
4.1용접 캐비티 개선을 위한 DOE 테스트
주요 영향인자(환류시간, 철망두께)의 최적값을 찾아 QFN 및 칩 용접층의 홀을 개선하였다. 솔더 페이스트는 SAC305 type4, 철망 형상은 그리드형(100% 개구도), 최고로 온도는 260℃, 기타 테스트 조건은 테스트 장비와 동일하였다. DOE 시험 및 결과는 Table 3에 나타내었다. Steel mesh 두께와 환류시간이 QFN과 칩 용접 Hole에 미치는 영향은 Figure 12에 나타내었다. 주요 영향요인의 상호작용 분석을 통해 100μm Steel mesh 두께를 사용하는 것으로 나타났다. 80초의 환류 시간은 QFN과 칩의 용접 캐비티를 크게 줄일 수 있습니다. QFN의 용접 캐비티율은 최대 27.8%에서 16.1%로 감소하고, 칩의 용접 캐비티율은 최대 20.5%에서 14.5%로 감소됩니다.
테스트에서는 최적의 조건(철망 두께 100μm, 환류 시간 80초)에서 1000개의 제품을 생산하고, 100QFN과 칩의 용접 캐비티율을 무작위로 측정했다. QFN의 평균 용접 캐비티율은 16.4%, 칩의 평균 용접 캐비티율은 14.7%였습니다. 칩과 칩의 용접 캐비티율은 확실히 감소했습니다.

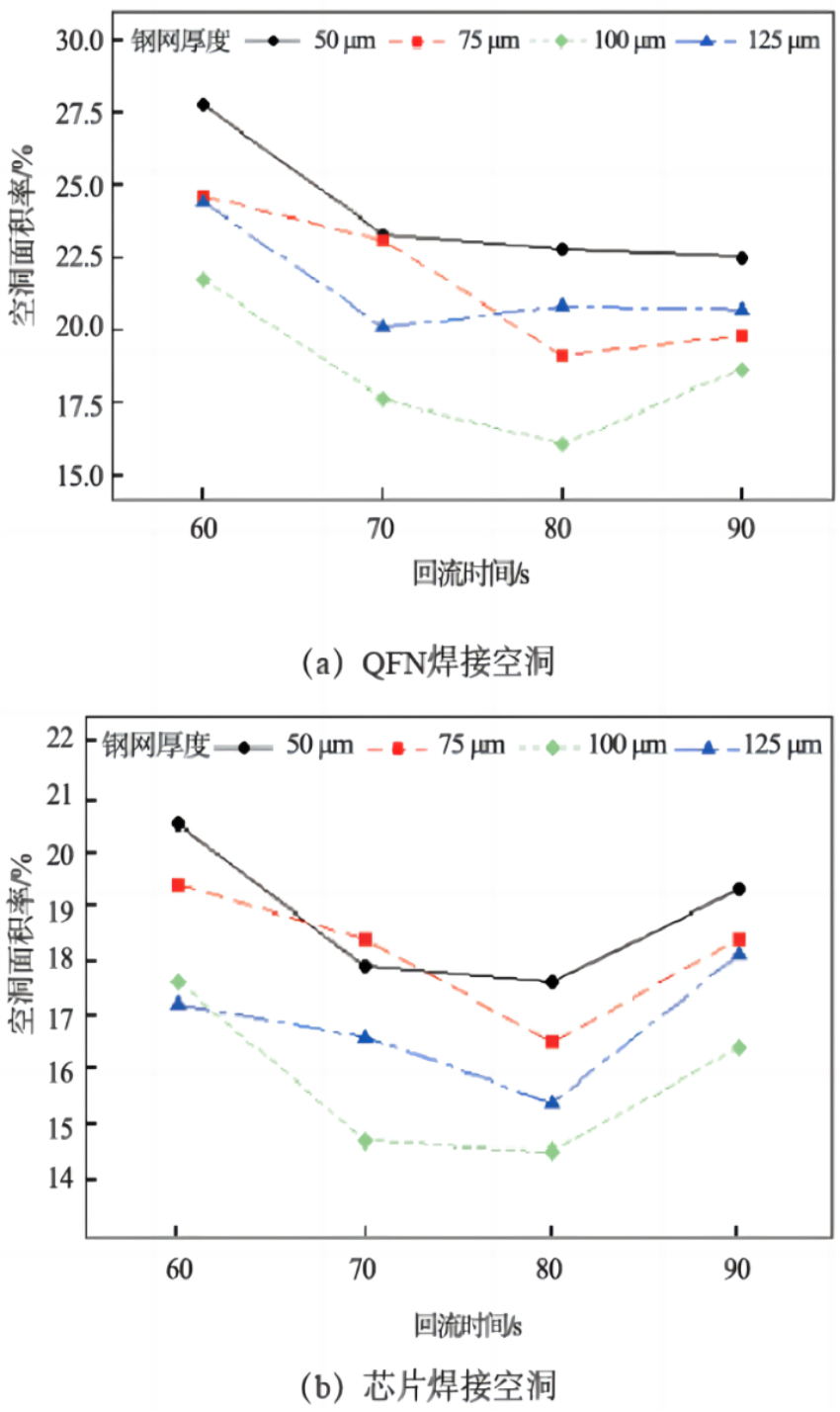
4.2 새로운 공정으로 용접 캐비티 개선
실제 생산 상황과 테스트에 따르면 칩 하단의 용접 캐비티 면적이 10% 미만인 경우 리드 본딩 및 성형 중에 칩 캐비티 위치 균열 문제가 발생하지 않는 것으로 나타났습니다. DOE에 의해 최적화된 공정 매개변수는 기존 솔더 페이스트 리플로우 용접의 구멍을 분석하고 해결하는 요구 사항을 충족할 수 없으며 칩의 용접 캐비티 면적 비율을 더욱 줄여야 합니다.
솔더에 덮인 칩은 솔더 내의 가스가 빠져 나가는 것을 방지하므로 솔더 코팅 가스를 제거하거나 줄임으로써 칩 바닥의 홀율을 더욱 줄입니다. 두 개의 솔더 페이스트 인쇄를 사용한 새로운 리플로우 용접 프로세스가 채택되었습니다. 하나의 솔더 페이스트 인쇄, 하나의 리플로우는 QFN을 덮지 않고 솔더에서 가스를 배출하는 베어 칩입니다. 2차 솔더 페이스트 인쇄, 패치 및 2차 환류의 구체적인 프로세스는 그림 13에 나와 있습니다.
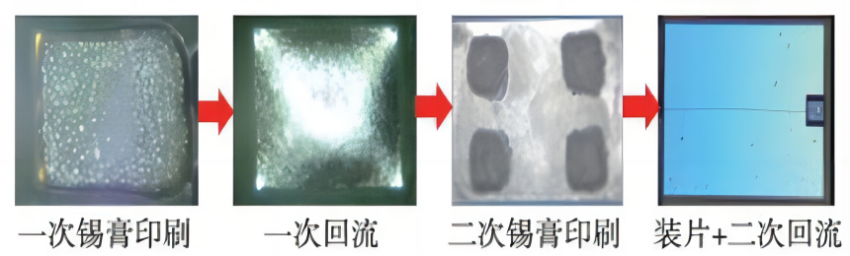
75μm 두께의 솔더 페이스트가 처음 인쇄되면 칩 커버가 없는 솔더에 포함된 가스의 대부분이 표면에서 빠져나오며 환류 후 두께는 약 50μm입니다. 1차 환류가 완료된 후 냉각된 응고된 솔더 표면에 작은 사각형이 인쇄됩니다(솔더 페이스트 양 감소, 가스 유출량 감소, 솔더 스패터 감소 또는 제거를 위해). 50μm의 두께(위의 테스트 결과는 100μm가 가장 적합하므로 2차 인쇄의 두께는 100μm입니다.50μm=50μm), 칩을 설치한 다음 다시 통과합니다. 80초 그림 14와 같이 첫 번째 인쇄 및 리플로우 후에는 솔더에 구멍이 거의 없으며 두 번째 인쇄에서는 솔더 페이스트가 작고 용접 구멍도 작습니다.
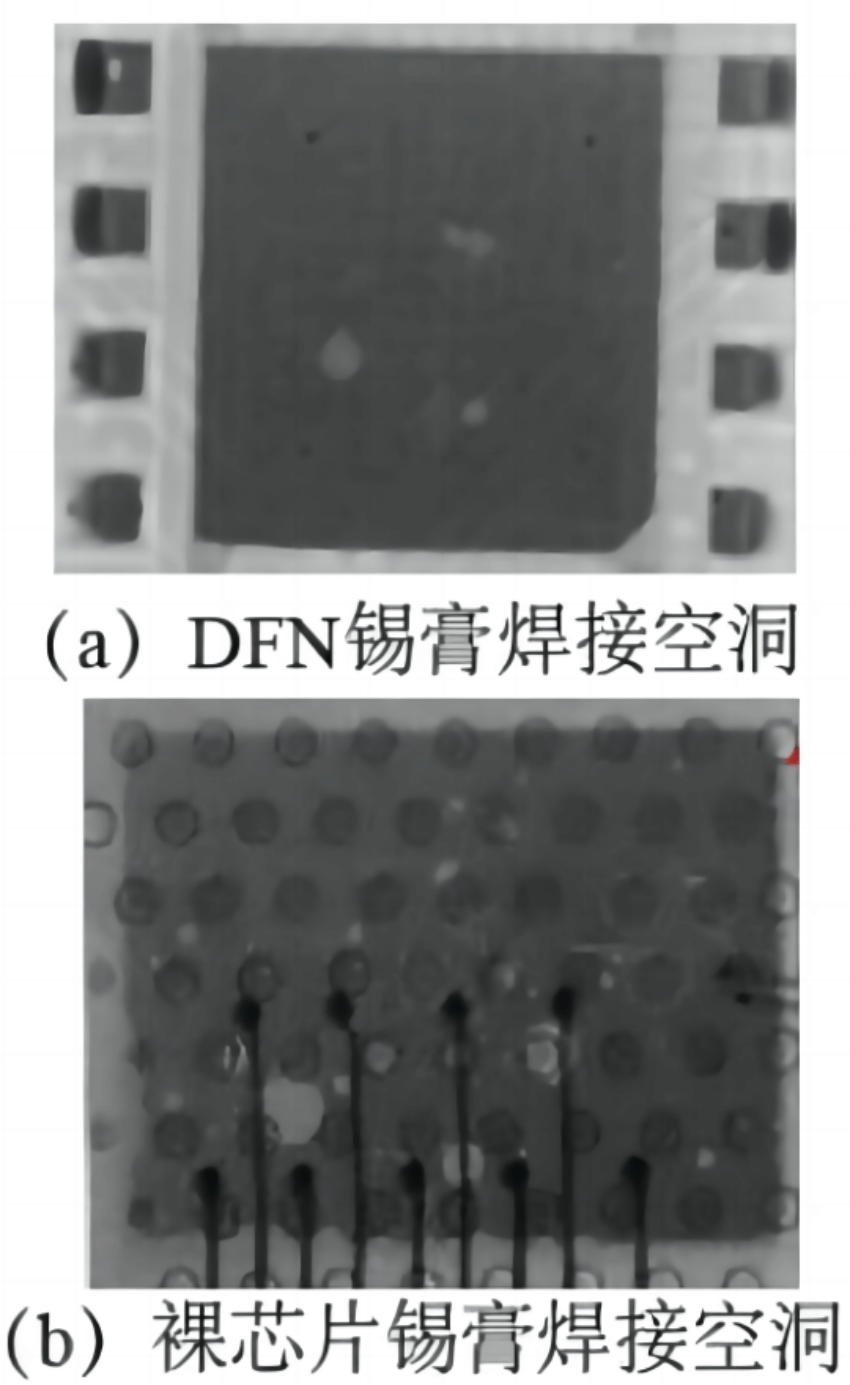
솔더 페이스트를 두 번 인쇄한 후 중공 드로잉
4.3 용접 캐비티 효과 검증
2000개의 제품을 생산(첫 번째 인쇄 강철 메쉬의 두께는 75μm, 두 번째 인쇄 강철 메쉬의 두께는 50μm), 기타 조건은 변경하지 않고 500 QFN 및 칩 용접 캐비티율을 무작위로 측정하여 새로운 공정을 발견했습니다. 첫 번째 환류 후 캐비티 없음, 두 번째 환류 후 QFN 최대 용접 캐비티율은 4.8%이고 칩의 최대 용접 캐비티율은 4.1%입니다. 그림 15와 같이 원래의 단일 페이스트 인쇄 용접 공정 및 DOE 최적화 공정과 비교하여 용접 캐비티가 크게 감소했습니다. 모든 제품의 기능 테스트 후에도 칩 균열이 발견되지 않았습니다.

5 요약
솔더 페이스트 프린팅 양과 환류 시간의 최적화는 용접 캐비티 면적을 줄일 수 있지만 용접 캐비티 비율은 여전히 큽니다. 두 가지 솔더 페이스트 프린팅 리플로우 용접 기술을 사용하면 용접 캐비티 비율을 효과적으로 최대화할 수 있습니다. QFN 회로 베어 칩의 용접 면적은 대량 생산시 각각 4.4mm x 4.1mm 및 3.0mm x 2.3mm가 될 수 있습니다. 리플로우 용접의 캐비티율을 5% 이하로 제어하여 리플로우 용접의 품질과 신뢰성을 향상시킵니다. 본 논문의 연구는 대면적 용접면의 용접 캐비티 문제를 개선하기 위한 중요한 참고자료를 제공한다.






